GB/T 14113-1993
基本信息
标准号: GB/T 14113-1993
中文名称:半导体集成电路封装术语
标准类别:国家标准(GB)
标准状态:现行
发布日期:1993-01-21
实施日期:1993-08-01
出版语种:简体中文
下载格式:.rar.pdf
下载大小:364079

标准分类号
标准ICS号:电子学>>31.200集成电路、微电子学
中标分类号:电子元器件与信息技术>>微电路>>L55微电路综合
出版信息
出版社:中国标准出版社
页数:平装16开, 页数:16, 字数:26千字
标准价格:12.0 元
相关单位信息
首发日期:1993-01-21
复审日期:2004-10-14
起草单位:机电部电子标准化所
归口单位:全国半导体器件标准化技术委员会
发布部门:国家技术监督局
主管部门:信息产业部(电子)
标准简介
本标准规定了半导体集成电路封装在生产制造、工程应用和产品交验等方面使用的基本术语。本标准适用于与半导体集成电路封装相关的生产、科研、教学和贸易等方面的应用。 GB/T 14113-1993 半导体集成电路封装术语 GB/T14113-1993 标准下载解压密码:www.bzxz.net
标准图片预览

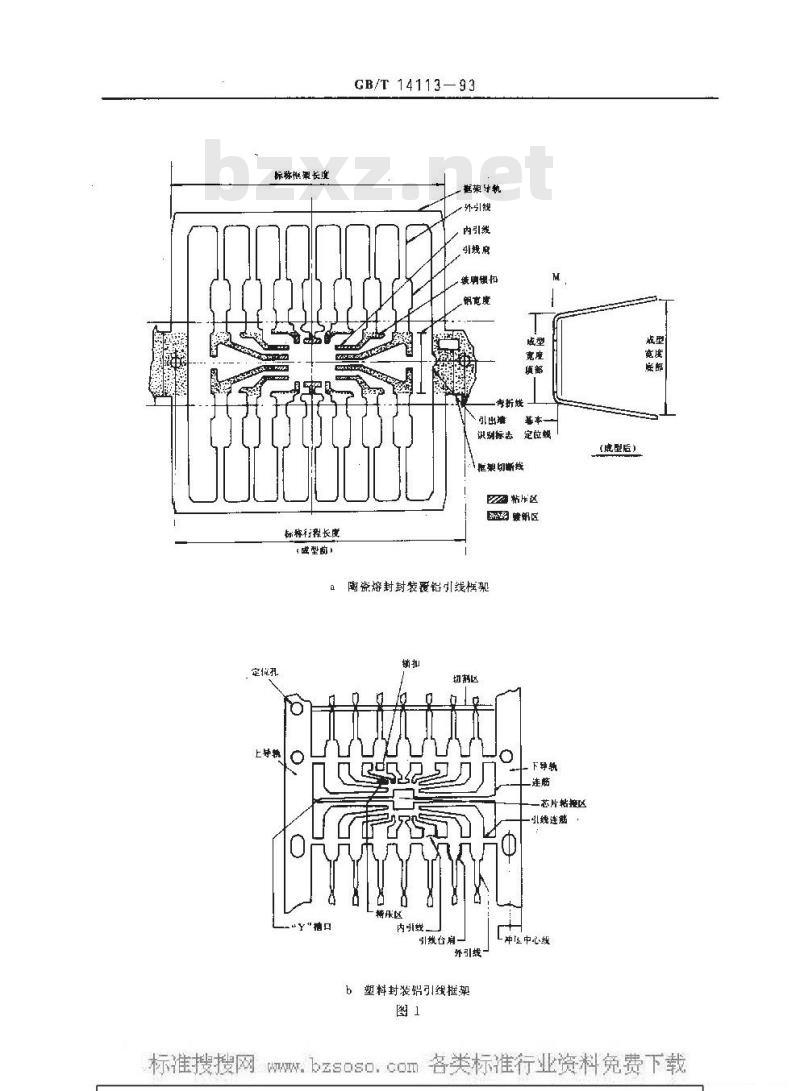
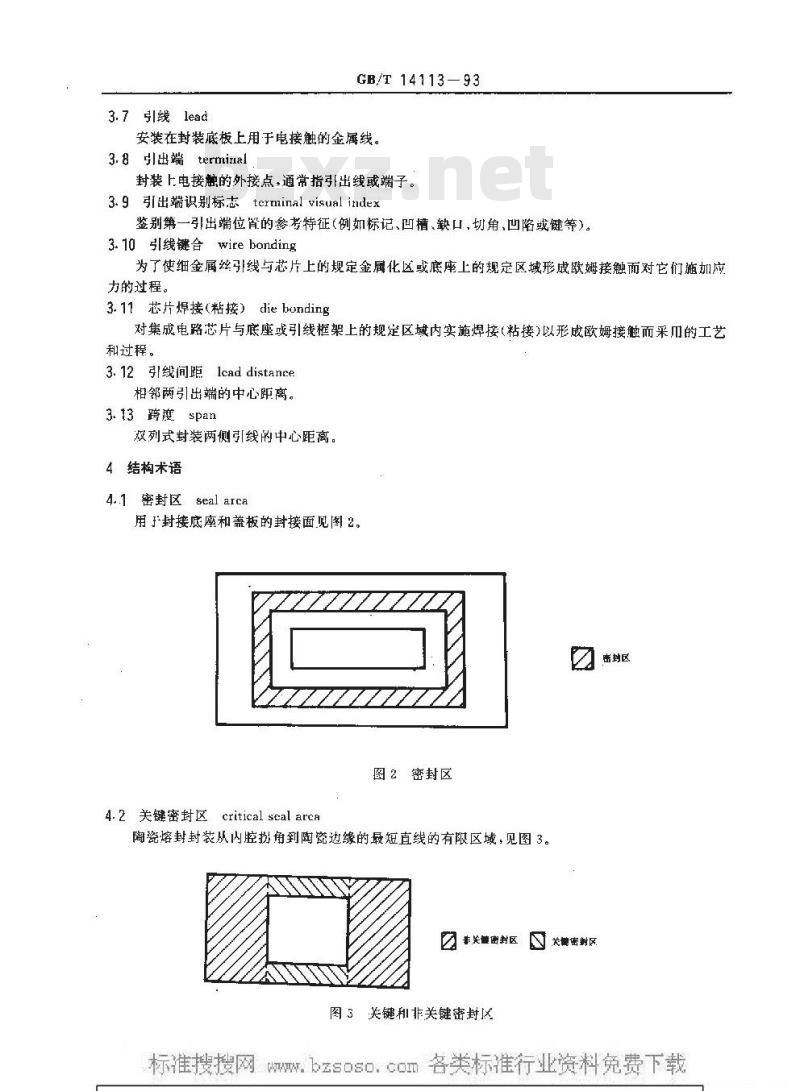


标准内容
中华人民共和国国家标准
半导体集成电路封装术语
Terminology of packages for
semiconductar integrated circuits1 主题内容与适用范围
GB/T 14113—93
本标准规定了半导体集成电路封装在生产制造、工程应用和产品交验等方面使用的基本术语。本标准适用于与半导体集成电路封装相关的生产、科研,教学和贸易等方面的应用。2引用标准
GB 9178集成电路术语
3通用术语
3.1 封装 package
半导体集成电路的全包封或部分包封体,它提供,机械保护,
环境保护;
外形尺寸。
封装可以包含或提供引出蜥,它对集成电路的热性能产生影响。3.2 底座 header
封装体中用来安装半导体芯片并已具备了芯片焊接(粘接)、引线键合和引出端等功能的部分,它是封装结构的基体。
3.3底板base
在陶瓷或金属封装中,构戒底座的--种片状陶瓷或金属零件。3.4盖板(管帽)cap
在陶瓷封装或金属底座上,采用金属或陶瓷制成片状或帽状结构,封接后对整个封装形成密封的一个零件。
3.5 上框 window frame
装在陶瓷封装表面上的个金属或陶瓷件在其上可焊接一个旧于密封的盖板。3.6引线框架、leadframes
采用冲制或刻蚀工艺制造,使具有定儿何图形和规定外形尺寸,提供陶瓷熔封或塑料封装引出线的一个或一组金属零件。引线框架各部位名称见图1a和图1b。国家技术监督局1993-01-21批准1993-08-01实施
标称提累长
标称程长虞
GB/T14113—93
燕莱牙轨
内引綫
一缺确馈扣
销高境
再折线
引出班
识别标
定应蝇
简然切斯线
粘作区
路幢第区
陶瓷熔封封装爱铝引线模架
定指孔
上导等
““推口
切书区
下静染
一芯片粘撞区
引线连
引鳞台扇一
外引线
b塑料封装铝引线挺架
冲压中心线
(魔型后)
W3.7 引线 lead
GB/T14113—93
安装在封装底板上用于电接触的金属线。3.8 引出端 terminal
封装上电接触的外接点,通常指引出线或端子。3.9引出端识别标志terminalvisualindex鉴别第一引出端位置的参考特征(例如标记、凹槽、缺口,切角、凹陷或键等)。3.10引线键合wirebonding
为了使细金属丝引线与芯片上的规定金属化区或底座上的规定区域形成欧姆接触而对它们施加应力的过程。
3.11芯片焊接(粘接)die bonding对集成电路芯片与底座或引线框架上的规定区域内实施焊接(粘接)以形成欧姆接触而采用的工艺和过程。
3.12引线间距Icad distanee
相邻两引出端的中心距离。
3. t3跨度span
双列式封装两侧引线的中心距离,4结构术语
4.1密封区seal arca
用封接底座和盖板的封接面见图2密封区
图22密封区
4.2关键密封区critical seal arca陶瓷熔封封装从内腔扮角到陶瓷边缘的最短直线的有限区域,见图3。 非关糖密封区关糖密封区
图3关键和非关键密封区
GB/T 14113—93
non-critical seal area
4.3非关键密封区
瓷熔封封装中在关键密封区以外的密封表面部分(见第4.2条图3)。4.4 连接区 conlact pad
陶瓷封装结构上,对外引线提供机械连接或电气连接的金属化区域。4.5 焊迹 fuotprint
陶瓷结构封装中连接区的图形
4. 6芯片粘接区 die attach area粘接芯片的区域。
4.7键合区bonding area
引线框架或陶瓷底座的内引线上,离引线端点规定的距离以内,用于引线键合的精压区或金属化区。
4.8 精压区 coined area
陶瓷熔封封装或塑料封装的引线框架上,被加工后的键合区表面(见第 3. 6 条图 1a 或图 1b)。4.9指形焊点bund finger
陶瓷扁平封装结构巾,用于引线键合的金属化区。4.10功能区functional area
塑封引线框架上的芯片粘接区和引线键合区的总称。4.11基准面datumplanc
确定封装结构上几何要素几何关系所依据的面,即为基准面,如第3.6条图1a所示,M即为基推面。
4.12 面 base plane
封装中的底面见图4。
支座商度
支座高度
4.13安装面seatingplane
a针相阵列封装
b陶瓷封装
为支座的特征平面(见第4.12条图4)或无支座时的基面。4. 14 支座 standoff
W.GB/T 14113—93
由封装结构特征所产生的基面和安装面之间的设计间隙(见第4.12条图4)。支座的应用和形状可由具体的封装结构来确定。
4.15平面度flatness
封装结构中一个表面对某一参考面的允许偏差,由包容实际表面月距离为最小的两平行平面的距离来表示。
4.16共面性coplanarity
引线框架上各引线端相对于基准面的距离偏差。4.17薄层layer
陶瓷封装的组成部分,是一种起隔离作用的,有或无金属化层的陶瓷层。平面形状和功能完全相同的多层组合,则视为一个薄层。4.18绝缘间隙isolatiangap
封装中相邻两导电区之问尤金体的空隙。5技术,工艺术语
5.1金属化metallization
在陶瓷基体上将某些难熔金属或合金浆料涂覆并烧成适用几仰图形的过程。5.2共烧cofired
将陶瓷利金属化层同时烧成的一种工艺和技术。5.3后金腐化post-metallization在完成陶瓷基片烧结后再进行金属化的一种工艺。5.4耐熔金属化refractorymetallization用高熔点(典型值超过1800C)金属或合金浆料实施金属化的过程。5.5 毛劑 burr
垂直或水平地附着在金属边缘上的母体材料碎眉或粘附在陶瓷边缘上的母体材料碎屑和异物颗粒。
5.6 飞边 fin
陶瓷或塑料基体边缘或拐角上的细小,轻微、有刃的羽状突出物。5.7 缺[ chip
陶瓷或塑料表面或边缘处没有完全穿透整个封装基休的缺损部位。在产品设计结构图中用长、宽和深给出缺口尺小(见图5)。
L:长魔
:深度
图5缺口
5.8 裂纹 crack
GB/T 14113-93
延伸到表面的裂缝或裂痕,不论其是否穿透整个陶瓷或塑料封装的厚度。5.9孔隙voids
在陶瓷表面上所指定金属化区或玻璃层的区域内,缺少金属化层或玻璃层而产生的缺损。5.10 异物 foreign material
粘附在封装各部位的非母体材料微粒。5.11斑点stain
有机或无机材料的外来物附着在封装表面上所形成的污点。5.12 凸起 projection
基体材料表面固有的突出部分。5.13凹坑pit
基体材料上具有见边缘的浅凹陷或非设计规定的压痕。5.14尚缩pullback
陶瓷基体边缘与金属化层或玻璃层端面之间的直线距离(见图6)。同摘
图6回缩、塌陷和悬伸
5.15塌陷rundown
金属化层或玻璃层材料沿陶瓷基体垂直方向的延伸部分(见第5.14条图6)。5.16悬伸overhang
玻璃层材料沿陶瓷基体水平方向的延伸部分(见第5.14条图6)。5. 17 压痕 slug marks
基体材料上的任意的机械划伤、压印和外界杂质所引起的无序凹坑。5.18气泡blister(bubble)
塑料封装体、陶瓷金属化层、玻璃层或金属化层中的或层中间的任何局部空隙。5.19变色diseolaration
经过规定的高温老炼后,封装链层,金属化层或引线框架覆铝层上颜色的任何变化。5.20分层delamination
陶瓷封装各薄层陶瓷间的空隙。5.21脱皮(剥落)peeling(flaking)金属化层、玻璃层、电镀层等从基体材料上分离。5.22引线偏移leadoffset
封装两对边引线的准直性。
5.23扭曲twist
引线框架或条带的一端相对于另一端的角位移(见图7)。5.24引线扭曲 lead twist
G/T 14113—93
报曲尺寸
参孝平面
图7扭曲
扭曲尺寸
A-按糖平面
塑封引线框的键合区偏离引线框架条带方向的角度(见图8)。图8引线扭曲
5. 25弯度(侧弯) camber
引线框架条带边缘在水平面内的直线度(见图9)。基体
图9弯度
5.26弓形bow
胸瓷熔封封装的引线框架条带边缘在垂直面内的直线度(见图10)。5.27卷曲coil set
能准利
GB/ 14113—93
凸弓形
阿寻形
图10弓形
塑料封装引线框架条带长度方向的弯曲见图11。精压面
精压面
5.28横弯crossbow
图11卷曲变形
引线框架宽度方向的弓形弯曲见图12。正向誉曲
基准面
厂反向卷面
基准面
W5.29斜度tilt
基推间
精压区平面与基准面的角度偏差.5.30刻系数etch factor
GB/T 14113—93
正肉卷曲一
反向曲
图12横向弯曲
蚀刻型引线框架的蚀刻深度与横向蚀刻(钻蚀)深度之比见图13。光晓济层
光射胶涂
E为蚀刻系数,
t为金属厚度!
为横向蚀刻(钻蚀)
F-0.5Xt/0
图13钻蚀和蚀刻系数
5.31钻蚀 undercut
蚀刻引线框架时,腐蚀剂对金属的横向浸蚀(见第5.30条图13)。5.32 壳温case temperature(Tc)安装芯片的封装表面上所规定参考点的温度。5.33安装表面温度moum temperalure(Tm)器件热交换安装界面(或主要热交换表面)上规定点的温度。5.34结温junction temperature(Tj)器件中主要发热部分的半导体结的温度5.35热阻thermalresistance(R)量度载体或封装以及安装技术逸热量的能力。W安装面
安装表面温度
分层·
非关键密封区
共面性…
弓形·
功能区·
关键密封区
后金属化
回缩·
基面·
基准面
GB/T14113—93
附录A
中文索引
(参考件)
结温·
金属化
键合区
精压区
绝缘间隙
连接区
密封区
耐熔金属化
平面度
蚀刻系数-
芯片粘接区
芯片焊接
bascplae
blister
houd finger
bonding area ..
buhhle
camber
case temperature(Tc)
cofired
coil set
coined area
contact pad
coplanarity
CB/T14113—93
引出端
引出端识别标志
引线框架
引线间距
引线键合
引线扭曲
引线偏移·
指形焊点
附录B
英文索引
(参考件)
W.critical seal area
crossbow
datum plane
telamination
die attach area
die bonding
disenloration
etch factor
flaking
flatness
foutprint
*e+++e++++e+.*
foreign material
functionel area
header
isolationgap
junctiontemperature(T)
lead distance
lcadframes
lead offset
lead twistbZxz.net
metallization.
mount temperature(Tm)
GB/T 14113—93
W.
小提示:此标准内容仅展示完整标准里的部分截取内容,若需要完整标准请到上方自行免费下载完整标准文档。
半导体集成电路封装术语
Terminology of packages for
semiconductar integrated circuits1 主题内容与适用范围
GB/T 14113—93
本标准规定了半导体集成电路封装在生产制造、工程应用和产品交验等方面使用的基本术语。本标准适用于与半导体集成电路封装相关的生产、科研,教学和贸易等方面的应用。2引用标准
GB 9178集成电路术语
3通用术语
3.1 封装 package
半导体集成电路的全包封或部分包封体,它提供,机械保护,
环境保护;
外形尺寸。
封装可以包含或提供引出蜥,它对集成电路的热性能产生影响。3.2 底座 header
封装体中用来安装半导体芯片并已具备了芯片焊接(粘接)、引线键合和引出端等功能的部分,它是封装结构的基体。
3.3底板base
在陶瓷或金属封装中,构戒底座的--种片状陶瓷或金属零件。3.4盖板(管帽)cap
在陶瓷封装或金属底座上,采用金属或陶瓷制成片状或帽状结构,封接后对整个封装形成密封的一个零件。
3.5 上框 window frame
装在陶瓷封装表面上的个金属或陶瓷件在其上可焊接一个旧于密封的盖板。3.6引线框架、leadframes
采用冲制或刻蚀工艺制造,使具有定儿何图形和规定外形尺寸,提供陶瓷熔封或塑料封装引出线的一个或一组金属零件。引线框架各部位名称见图1a和图1b。国家技术监督局1993-01-21批准1993-08-01实施
标称提累长
标称程长虞
GB/T14113—93
燕莱牙轨
内引綫
一缺确馈扣
销高境
再折线
引出班
识别标
定应蝇
简然切斯线
粘作区
路幢第区
陶瓷熔封封装爱铝引线模架
定指孔
上导等
““推口
切书区
下静染
一芯片粘撞区
引线连
引鳞台扇一
外引线
b塑料封装铝引线挺架
冲压中心线
(魔型后)
W3.7 引线 lead
GB/T14113—93
安装在封装底板上用于电接触的金属线。3.8 引出端 terminal
封装上电接触的外接点,通常指引出线或端子。3.9引出端识别标志terminalvisualindex鉴别第一引出端位置的参考特征(例如标记、凹槽、缺口,切角、凹陷或键等)。3.10引线键合wirebonding
为了使细金属丝引线与芯片上的规定金属化区或底座上的规定区域形成欧姆接触而对它们施加应力的过程。
3.11芯片焊接(粘接)die bonding对集成电路芯片与底座或引线框架上的规定区域内实施焊接(粘接)以形成欧姆接触而采用的工艺和过程。
3.12引线间距Icad distanee
相邻两引出端的中心距离。
3. t3跨度span
双列式封装两侧引线的中心距离,4结构术语
4.1密封区seal arca
用封接底座和盖板的封接面见图2密封区
图22密封区
4.2关键密封区critical seal arca陶瓷熔封封装从内腔扮角到陶瓷边缘的最短直线的有限区域,见图3。 非关糖密封区关糖密封区
图3关键和非关键密封区
GB/T 14113—93
non-critical seal area
4.3非关键密封区
瓷熔封封装中在关键密封区以外的密封表面部分(见第4.2条图3)。4.4 连接区 conlact pad
陶瓷封装结构上,对外引线提供机械连接或电气连接的金属化区域。4.5 焊迹 fuotprint
陶瓷结构封装中连接区的图形
4. 6芯片粘接区 die attach area粘接芯片的区域。
4.7键合区bonding area
引线框架或陶瓷底座的内引线上,离引线端点规定的距离以内,用于引线键合的精压区或金属化区。
4.8 精压区 coined area
陶瓷熔封封装或塑料封装的引线框架上,被加工后的键合区表面(见第 3. 6 条图 1a 或图 1b)。4.9指形焊点bund finger
陶瓷扁平封装结构巾,用于引线键合的金属化区。4.10功能区functional area
塑封引线框架上的芯片粘接区和引线键合区的总称。4.11基准面datumplanc
确定封装结构上几何要素几何关系所依据的面,即为基准面,如第3.6条图1a所示,M即为基推面。
4.12 面 base plane
封装中的底面见图4。
支座商度
支座高度
4.13安装面seatingplane
a针相阵列封装
b陶瓷封装
为支座的特征平面(见第4.12条图4)或无支座时的基面。4. 14 支座 standoff
W.GB/T 14113—93
由封装结构特征所产生的基面和安装面之间的设计间隙(见第4.12条图4)。支座的应用和形状可由具体的封装结构来确定。
4.15平面度flatness
封装结构中一个表面对某一参考面的允许偏差,由包容实际表面月距离为最小的两平行平面的距离来表示。
4.16共面性coplanarity
引线框架上各引线端相对于基准面的距离偏差。4.17薄层layer
陶瓷封装的组成部分,是一种起隔离作用的,有或无金属化层的陶瓷层。平面形状和功能完全相同的多层组合,则视为一个薄层。4.18绝缘间隙isolatiangap
封装中相邻两导电区之问尤金体的空隙。5技术,工艺术语
5.1金属化metallization
在陶瓷基体上将某些难熔金属或合金浆料涂覆并烧成适用几仰图形的过程。5.2共烧cofired
将陶瓷利金属化层同时烧成的一种工艺和技术。5.3后金腐化post-metallization在完成陶瓷基片烧结后再进行金属化的一种工艺。5.4耐熔金属化refractorymetallization用高熔点(典型值超过1800C)金属或合金浆料实施金属化的过程。5.5 毛劑 burr
垂直或水平地附着在金属边缘上的母体材料碎眉或粘附在陶瓷边缘上的母体材料碎屑和异物颗粒。
5.6 飞边 fin
陶瓷或塑料基体边缘或拐角上的细小,轻微、有刃的羽状突出物。5.7 缺[ chip
陶瓷或塑料表面或边缘处没有完全穿透整个封装基休的缺损部位。在产品设计结构图中用长、宽和深给出缺口尺小(见图5)。
L:长魔
:深度
图5缺口
5.8 裂纹 crack
GB/T 14113-93
延伸到表面的裂缝或裂痕,不论其是否穿透整个陶瓷或塑料封装的厚度。5.9孔隙voids
在陶瓷表面上所指定金属化区或玻璃层的区域内,缺少金属化层或玻璃层而产生的缺损。5.10 异物 foreign material
粘附在封装各部位的非母体材料微粒。5.11斑点stain
有机或无机材料的外来物附着在封装表面上所形成的污点。5.12 凸起 projection
基体材料表面固有的突出部分。5.13凹坑pit
基体材料上具有见边缘的浅凹陷或非设计规定的压痕。5.14尚缩pullback
陶瓷基体边缘与金属化层或玻璃层端面之间的直线距离(见图6)。同摘
图6回缩、塌陷和悬伸
5.15塌陷rundown
金属化层或玻璃层材料沿陶瓷基体垂直方向的延伸部分(见第5.14条图6)。5.16悬伸overhang
玻璃层材料沿陶瓷基体水平方向的延伸部分(见第5.14条图6)。5. 17 压痕 slug marks
基体材料上的任意的机械划伤、压印和外界杂质所引起的无序凹坑。5.18气泡blister(bubble)
塑料封装体、陶瓷金属化层、玻璃层或金属化层中的或层中间的任何局部空隙。5.19变色diseolaration
经过规定的高温老炼后,封装链层,金属化层或引线框架覆铝层上颜色的任何变化。5.20分层delamination
陶瓷封装各薄层陶瓷间的空隙。5.21脱皮(剥落)peeling(flaking)金属化层、玻璃层、电镀层等从基体材料上分离。5.22引线偏移leadoffset
封装两对边引线的准直性。
5.23扭曲twist
引线框架或条带的一端相对于另一端的角位移(见图7)。5.24引线扭曲 lead twist
G/T 14113—93
报曲尺寸
参孝平面
图7扭曲
扭曲尺寸
A-按糖平面
塑封引线框的键合区偏离引线框架条带方向的角度(见图8)。图8引线扭曲
5. 25弯度(侧弯) camber
引线框架条带边缘在水平面内的直线度(见图9)。基体
图9弯度
5.26弓形bow
胸瓷熔封封装的引线框架条带边缘在垂直面内的直线度(见图10)。5.27卷曲coil set
能准利
GB/ 14113—93
凸弓形
阿寻形
图10弓形
塑料封装引线框架条带长度方向的弯曲见图11。精压面
精压面
5.28横弯crossbow
图11卷曲变形
引线框架宽度方向的弓形弯曲见图12。正向誉曲
基准面
厂反向卷面
基准面
W5.29斜度tilt
基推间
精压区平面与基准面的角度偏差.5.30刻系数etch factor
GB/T 14113—93
正肉卷曲一
反向曲
图12横向弯曲
蚀刻型引线框架的蚀刻深度与横向蚀刻(钻蚀)深度之比见图13。光晓济层
光射胶涂
E为蚀刻系数,
t为金属厚度!
为横向蚀刻(钻蚀)
F-0.5Xt/0
图13钻蚀和蚀刻系数
5.31钻蚀 undercut
蚀刻引线框架时,腐蚀剂对金属的横向浸蚀(见第5.30条图13)。5.32 壳温case temperature(Tc)安装芯片的封装表面上所规定参考点的温度。5.33安装表面温度moum temperalure(Tm)器件热交换安装界面(或主要热交换表面)上规定点的温度。5.34结温junction temperature(Tj)器件中主要发热部分的半导体结的温度5.35热阻thermalresistance(R)量度载体或封装以及安装技术逸热量的能力。W安装面
安装表面温度
分层·
非关键密封区
共面性…
弓形·
功能区·
关键密封区
后金属化
回缩·
基面·
基准面
GB/T14113—93
附录A
中文索引
(参考件)
结温·
金属化
键合区
精压区
绝缘间隙
连接区
密封区
耐熔金属化
平面度
蚀刻系数-
芯片粘接区
芯片焊接
bascplae
blister
houd finger
bonding area ..
buhhle
camber
case temperature(Tc)
cofired
coil set
coined area
contact pad
coplanarity
CB/T14113—93
引出端
引出端识别标志
引线框架
引线间距
引线键合
引线扭曲
引线偏移·
指形焊点
附录B
英文索引
(参考件)
W.critical seal area
crossbow
datum plane
telamination
die attach area
die bonding
disenloration
etch factor
flaking
flatness
foutprint
*e+++e++++e+.*
foreign material
functionel area
header
isolationgap
junctiontemperature(T)
lead distance
lcadframes
lead offset
lead twistbZxz.net
metallization.
mount temperature(Tm)
GB/T 14113—93
W.
小提示:此标准内容仅展示完整标准里的部分截取内容,若需要完整标准请到上方自行免费下载完整标准文档。